

-
CEDAR思達
-
Stucchi思多奇
-
NITTO KOHKI日...
-
Sankei
-
KYOWA協(xié)和工業(yè)
- DIT東日技研
- AITEC艾泰克
-
SIGMAKOKI西格瑪...
- REVOX萊寶克斯
- CCS 希希愛視
- SIMCO思美高
- POLARI0N普拉瑞
- HOKUYO北陽電機
- SSD西西蒂
- EMIC 愛美克
- TOFCO東富科
-
打印機
- HORIBA崛場
- OTSUKA大冢電子
- MITAKA三鷹
- EYE巖崎
- KOSAKA小坂
-
SAGADEN嵯峨電機
- TOKYO KEISO東...
- takikawa 日本瀧...
- Yamato雅馬拓
- sanko三高
- SEN特殊光源
-
SENSEZ 靜雄傳感器
- marktec碼科泰克
- KYOWA共和
- FUJICON富士
- SANKO山高
-
Sugiyama杉山電機
-
Osakavacuum大...
-
YAMARI 山里三洋
- ACE大流量計
- KEM京都電子
- imao今尾
- AND艾安得
- EYELA東京理化
- ANRITSU安立計器
- JIKCO 吉高
- NiKon 尼康
- DNK科研
- Nordson諾信
- PISCO匹斯克
- NS精密科學
- NDK 日本電色
-
山里YAMARI
- SND日新
-
Otsuka大塚電子
- kotohira琴平工業(yè)
- YAMABISHI山菱
- OMRON歐姆龍
- SAKURAI櫻井
- UNILAM優(yōu)尼光
- ONO SOKKI小野測...
-
U-Technology...
- ITON伊藤
- chuhatsu中央發(fā)明...
- TOADKK東亞
- HOYA豪雅
- COSMOS日本新宇宙
-
UENO上野精機
- DSK電通產(chǎn)業(yè)
-
POLARION普拉瑞
- LUCEO魯機歐
- ThreeBond三鍵
-
HAMAMASTU濱松
-
TML東京測器
- SHINAGAWA SO...
- IMV愛睦威
- custom 東洋計量
- yuasa 尤阿薩
- HAYASHI林時計
- SIBATA柴田科學
- SEN日森特殊光源
-
HSK 平原精機
-
SOMA相馬光學
- iwata巖田
- MUSASHI武藏
- USHIO牛尾
- ACTUNI阿庫圖
- ORC歐阿希
- DRY-CABI德瑞卡比
- COSMO科斯莫
-
SHOWASOKKI昭和...
-
CHUBUSEKI中部精...
-
SAMCO薩姆肯
- navitar 納維塔
- ASKER 高分子計器
- KOSAKA Labor...
- EMIC愛美克
-
OPTEX奧泰斯
- NISSIN日進電子
- TANDD 蒂和日
- FUJI TERMINA...
- TAKASAGO高砂
- TAKIKAWA瀧川
- SUGAWARA菅原
- MACOME碼控美
-
FURUKAWA古河
-
TSUBOSAKA壺坂
- mitutoyo 三豐
- HAYASHI 林時計
- HOZAN 寶山
- FEI SEM電子顕微鏡
- YUASA尤阿薩
- SAKAGUCHI坂口電...
-
MDCOM 株式會社
-
inflidge 英富麗
- RKC 理化工業(yè)
- MORITEX茉麗特
- LIGHTING 光屋L...
- TEITSU帝通
- Excel聽音機
- SERIC索萊克
-
FUJI富士化學
-
TONCON拓豐
-
SHINKO新光電子
- Ono Sokki 小...
- 樂彩
- IIJIMA 飯島電子
- THOMAS托馬斯
- JIKCO吉高
- 分散材料研究所
-
NAVITAR納維塔
- Cho-Onpa 超音波...
- revox 萊寶克斯
- Toki Sangyo ...
- SUPERTOOL世霸
- EIWA榮和
- FUJITERMINAL...
- TOYOX東洋克斯
- AMAYA天谷制作所
-
TSUBAKI NAKA...
- TOPCON 拓普康
- NIKKATO日陶
- ITOH伊藤
- NEWKON新光
- SIBATA柴田
-
TAISEI
-
MITSUI三井電氣
-
加熱器
OTSUKA大塚電子關(guān)于了解薄膜厚度評估 測量方法
1. 簡介
在城市中看到智能手機和平板電腦已經(jīng)不是什么稀奇了,但事實上,薄膜技術(shù)在這些突飛猛進的背后有著巨大的影響。 換句話說,半導(dǎo)體是高科技器件的代表,LCD由薄膜堆疊技術(shù)組成。 此外,只要想想你周圍的事物,你就會意識到薄膜作為核心技術(shù)正在變得不可計數(shù)。
? CPU、存儲器和其他半導(dǎo)體器件
、LCD 和其他顯示設(shè)備
、磁盤、光盤和其他存儲介質(zhì)
、鏡頭、在顯示設(shè)備表面施加的無反射膜
、防潮膜等聚合物產(chǎn)品的表面改性膜等。
除了這些器件的薄膜制造設(shè)備外,測量和評估設(shè)備也變得至關(guān)重要。
2. 薄膜的測量方法
觸針是直接和*原始的方法,以及使用電子顯微鏡觀察橫截面的方法,誤差很小,但另一方面,存在對樣品造成致命損害的風險。 因此,它不適合質(zhì)量控制。
另一方面,使用分光光度計的方法很容易,并且可以以非接觸式測量,只要知道折射率,就可以高精度地測量,但由于折射率因沉積條件而異,因此需要以某種方式測量它。 由于折射率是光具有波的性質(zhì),并且由于與透射物質(zhì)的相互作用而產(chǎn)生的現(xiàn)象,因此光譜厚度測量與采用相同方法的折射率測量是不可分割的。 換句話說,由于薄膜的折射率和吸收系數(shù)是由材料特有的物理性能決定的,因此從薄膜厚度測量的角度來看,這是使分析復(fù)雜化的因素,但從了解薄膜物理性能的角度來看,這也是一個非常重要的方法。 特別是在半導(dǎo)體材料中,由于其組成和雜質(zhì)的比例很重要,因此當薄膜成分發(fā)生變化或沉積條件發(fā)生變化時,它也會成為監(jiān)測器。
此外,由于在光譜中增加了偏振分析功能,可以更詳細地觀察光與物質(zhì)之間的相互作用,因此利用這一原理的分光橢圓計先進的薄膜厚度測量裝置也已商業(yè)化。 該設(shè)備不僅能夠高精度地測量更薄的薄膜和折射率本身,而且還能夠?qū)Ρ∧みM行各向異性分析。
現(xiàn)在,在下一節(jié)中,我想更詳細地解釋光譜厚度分析的原理。
3. 光干涉效應(yīng)的薄膜厚度分析
使用光干涉效應(yīng)的薄膜厚度計*常見的方法是峰谷方法(PV 方法)。 原理很簡單,它利用了在膜表面反射的光和背面反射的光相互干擾,當光的相位匹配時,強度增加,當偏移時減弱。 因此,在光譜上觀察到反射強度隨波長變化而變化的干涉模式。 具體來說,PV方法根據(jù)這種圖案的峰值和谷波長確定薄膜厚度。
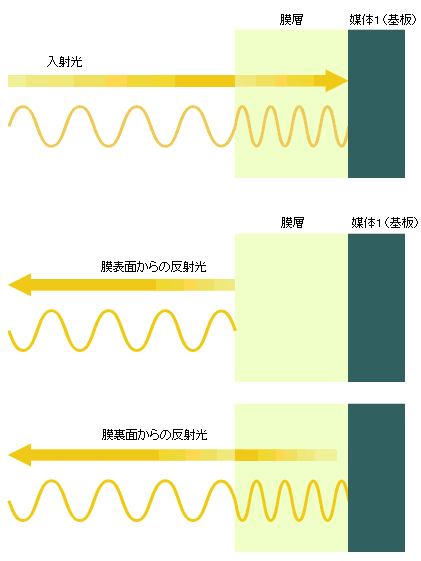
由于光通過膜層兩次合成,因此 n= 折射率和 d = 厚度僅產(chǎn)生**個光路差。 這是因為光在膜層中的傳輸速度是n倍,這就是為什么需要折射率的原因。 *后,重要的是反射光的相位是如何變化的。 也就是說,在折射率較大的介質(zhì)上反射時,相位不會發(fā)生變化,因此波長的整數(shù)倍為光路差 2nd 的波長為峰值。 相反,在低介質(zhì)上反射會導(dǎo)致 180 度偏差。 換句話說,在空氣/膜/空氣組合的背面,相位偏移180度,使波長的整數(shù)倍光路差2nd成為谷。 如果折射率已知,則根據(jù)這種關(guān)系確定厚度。 此外,折射率的大小也可以根據(jù)光路差 2nd 的整數(shù)倍的波長是峰值還是谷值來確定。
此外,在峰值和谷以外的波長上,通過彎曲擬合每個波長的反射強度和理論值,可以確定折射率以及薄膜厚度值。
4.復(fù)雜折射率分析
薄膜的光吸收系數(shù)被視為消光系數(shù) k。 化學分析中使用的吸光度的差異通過乘以波長,與折射率一樣無尺寸化。 此外,在電磁波的理論方程中使用折射率 n 和消光系數(shù) k,將復(fù)雜折射率 N 表示為簡化公式,如下式所示。 與真空中相比,光在折射率為 n 的介質(zhì)中移動得較慢,當消光系數(shù)增加時,強度會衰減。
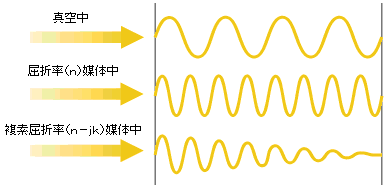
N=n-jk
如果僅測量薄膜厚度,則消光系數(shù)只會增加參數(shù),使分析變得困難,因此通常使用近紅外光測量測量光源,并在沒有吸收的波長下進行測量。 在液晶濾色片中,著色是質(zhì)量的重要因素,因此可能會增加著色,特別是由于干擾,甚至改變顯示設(shè)備的色調(diào)。 此外,在半導(dǎo)體領(lǐng)域,k的測量變得越來越重要,因為它是晶體內(nèi)部電子狀態(tài)水平的重要指標。
此外,由于絕緣膜的著色會導(dǎo)致器件性能問題,因此需要設(shè)置沉積條件,以降低 k。
消光系數(shù) k 可以從反射光譜中**確定,如果光譜形狀已知,則可以利用克拉默斯-克羅尼希在折射率和消光系數(shù)之間的關(guān)系,從而減少參數(shù)。 但是,當光譜形狀發(fā)生變化時,測量精度并不高。 此外,如果光譜模式未知,則無法從反射光譜中確定 k。
為了高精度地測量薄膜的消光系數(shù),測量的透射光譜必須與光譜橢圓光譜和反射光譜相結(jié)合。 這種方法相當常見,但缺點是,它**于透明基板。
硅基板的折射率得到了很好的研究,文獻也很多,但盡管如此,文獻中的數(shù)字卻大相徑庭。 由于通常的沉積是在Si基板上進行的,因此,即使折射率和消光系數(shù)不同,由此產(chǎn)生的反射光譜和光譜橢圓光譜也完全符合理論計算。 近年來,外延生長的Si膜被粘貼在絕緣基板上,并用于半導(dǎo)體基板,由于光在這種Si膜中透射,消光系數(shù)的差異直接反映在光譜中。 換句話說,即使使用文獻值,也不可能準確分析測量光譜,從而導(dǎo)致與文獻值之間的偏差。 換句話說,文獻值具有相當大的誤差。
5. 橢圓測量
這種測量方法的歷史非常悠久,可以追溯到19世紀。 近年來,光譜橢圓法之所以如此流行,是因為它在分析方法方面取得了長足的進步。 換句話說,一種新的舊測量方法就是橢圓測量。
在單波長橢圓體中,薄膜厚度值由橢圓體參數(shù)(如 tan_ 或 * )簡單計算,但多層膜使模型表達式變得過于復(fù)雜,因此不容易確定。 因此,通過改變波長、進行參數(shù)擬合和多變量分析,可以分析多層膜,但近年來,由于個人電腦的進步大大縮短了分析時間,因此得到了廣泛的應(yīng)用。
橢圓具有橢圓的含義。 由于光是波,當直行方向的偏振光的相位偏移 90 度時,它變?yōu)閳A偏振光。 如下圖所示,從光的行進方向看偏振方向,它隨著時間的推移向左 旋轉(zhuǎn)。 如果相位偏移不是 90 度,則為橢圓。 偏振分析稱為橢圓偏振分析儀,因為它分析橢圓偏振光。 光具有波的性質(zhì)。 換句話說,光譜橢圓測量充分利用了三種信息:強度、相位和波長。

為什么分析橢圓偏振光需要薄膜厚度? P 波是與反射面法線平行的偏振光,S 波是與法線成直角的偏振分量的名稱。 對于薄膜厚度測量,光譜橢圓測量始終通過具有恒定入射角的反射測量進行。 除了 P 波和 S 波的表面反射率不同外,反射率比還受到光干擾的影響,因此為 tan。 此外,由于薄膜介質(zhì)中光的進度速度不同,會產(chǎn)生相位差。 此外,由于P波和S波在反射過程中的相位變化不同,因此它們會產(chǎn)生相位差。 因此,相位差也會隨薄膜厚度而變化。 這是光譜橢圓法測量薄膜厚度的原理。
在沒有公式的條件下解釋愛立浦奏的原理是極其困難的,我認為阿扎穆斯的電磁解釋是*容易理解的。 換句話說,遵循公式是*準確、*容易理解的,如果不使用公式,則從光譜形狀解釋可能更容易理解。
光譜橢圓法的折射率和薄膜厚度測量是一種非常敏感的方法,但如果薄膜厚度較大,則光譜變化會表現(xiàn)出細微的 n 差異。 利用這一特性,我們經(jīng)常討論膜界面的狀態(tài)和膜縱向密度梯度,但這種詳細分析存在一些風險。 這是因為有許多因素可以改變光譜,特別是在很大程度上取決于膜表面的狀態(tài),因此可能不清楚哪個是真正的膜模型。
光譜橢圓法也有其局限性。 當薄膜的薄膜約為幾納米時,它大約是光波長的百分之一,需要nd,但很難分離兩者。 這種缺點也是光譜學的一個常見問題。
6. 結(jié)構(gòu)分析
光譜法不僅允許單層膜,還允許更復(fù)雜的結(jié)構(gòu)分析。
例如,對于高速、節(jié)能的 SOI(Si 夾層 SiO2 結(jié)構(gòu)),表面層的 Si 和中央 SiO2 層的厚度都會影響質(zhì)量,但光譜法允許測量此類多層結(jié)構(gòu)中每一層的薄膜厚度。
此外,退火的ITO(透明導(dǎo)電膜)提高了透明度和導(dǎo)電性,但膜質(zhì)量可能會在加熱表面和難以傳遞熱量的基板側(cè)逐漸改變。
也可以分析這種膜質(zhì)量厚度方向的階段性變化。
此外,還可以分析折射率因液晶方向而異的材料的三維折射率,并分析特定區(qū)域內(nèi)薄膜厚度的不均勻性(不均勻性)。
我們非常重視這些結(jié)構(gòu)分析,并專注于開發(fā)。
此外,在分析算法方面,我們每天都在努力改進和開發(fā),以滿足對*新技術(shù)的需求。
陣容列表




